当前位置:技术&应用 >
单组份导热粘接方案,兼顾柔性减震与可靠气密 发布时间:2025-12-31 17:41:00 浏览次数:
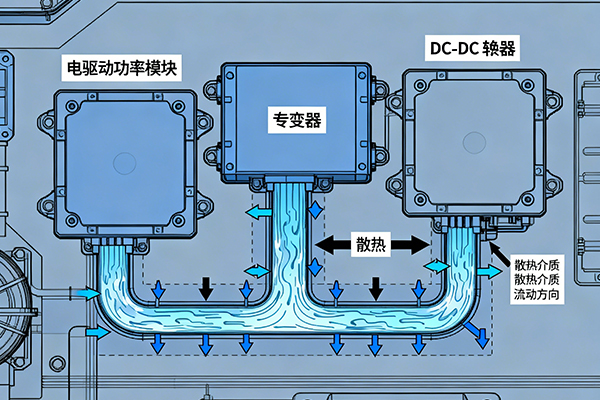
核心特性与优势
单组份设计,现场点涂/涂覆即可固化,显著简化工艺流程,减少原材料管理成本与错配风险。
导热性能稳定,结合柔性粘接层,在保障热通路的同时缓解热膨胀和机械应力,提升可靠性。
柔性减震效果出色,胶层具备合适的弹性模量与韧性,抵御振动、冲击及长期热循环带来的微位移。
气密性可靠,形成均匀密封层,抑制水汽与空气侵入,适应高湿或冷热往返等苛刻环境。
宽温与耐候性能优越,在多种工况下保持粘结强度与形状稳定,长期可靠性更具可预测性。
应用场景与适用领域
电子封装、功率模块、LED模组、通信基站、传感器、汽车电子,以及光伏与新能源逆变等对热管理、减震与密封性并重的场景。
适用于薄型化、轻量化设计的边缘封装与结构件粘结,帮助实现更紧凑的热通道和更高的结构刚性。
工作原理与验证要点
底材适配性广:对基材表面处理容错度高,能与多种金属、陶瓷、塑料基材形成稳定粘结。
集成性能经验证:通过导热、热循环保温、振动与冲击、长期气密性等测试,证明在实际工况下的稳定性与可控性。
可靠性评估涵盖环境与寿命:在高湿、盐雾、热循环等工况下保持粘结与密封性能的一致性。
为何选择这套方案
一体化解决:在同一材料体系中兼具导热、柔性减震与气密性,降低系统复杂度与成本。
可预测性强:单组份结构减少混配不确定性,提升良率与产线稳定性。
应用灵活性高:从小型模块到中大型封装均可适用,兼容多种封装工艺与装配线。


